近日,麻豆a片
光电材料与器件研究团队博士生李磊与导师合作在第三代宽禁带半导体材料 GaN HEMT研究方面取得突破性进展。相关成果以“Characteristics of transport properties in double barrier AlGaN/GaN HEMT with ultra-high density 2DEG and high breakdown voltage ”为题,发表在Nature Index著名学术期刊《Applied Physics Letters》上。
GaN 作为宽禁带半导体材料,广泛应用于深紫外光电器件、高压功率器件及极端环境传感器。氮化镓高电子迁移率晶体管(GaN HEMTs)因其高密度二维电子气(2DEG)和高电子迁移率,已成为广泛应用的功率器件。GaN HEMTs的关键优势包括低导通电阻和高击穿电压,使其适用于对效率和可靠性要求严苛的应用场景。该工作针对双势垒AlGaN/GaN高电子迁移率晶体管(DB HEMT)展开探究,旨在实现超高二维电子气(2DEG)密度与提升击穿电压的同步优化。器件采用不同铝组分的两层AlGaN结构,在AlGaN/GaN界面形成主量子阱,于AlGaN/AlGaN界面构建子量子阱。TCAD仿真显示,子量子阱的引入在高漏极偏压下能重新分布电场与载流子传输。尽管DB-HEMT的峰值电场强度与传统单势垒HEMT相当,但最高电场区域与最大载流子浓度区域在空间上实现解耦。这种电场-载流子解耦效应使碰撞电离区空间展宽,并抑制局部自持雪崩的形成,从而提升击穿电压。为验证仿真结果,我们制造了一款二维电子气密度高达2.58×1013 cm-2、平均方阻低至268 Ω/sq且击穿电压超过1.5 kV的双阻挡层高电子迁移率晶体管(DB-HEMT)。在120℃和-5 V偏置条件下,栅极泄漏电流低于10 µA/mm,展现出良好的高温稳定性。这些结果阐明了双势垒层氮化镓高电子迁移率晶体管击穿增强的物理机理,并为高压氮化镓功率器件的设计提供了实用策略。
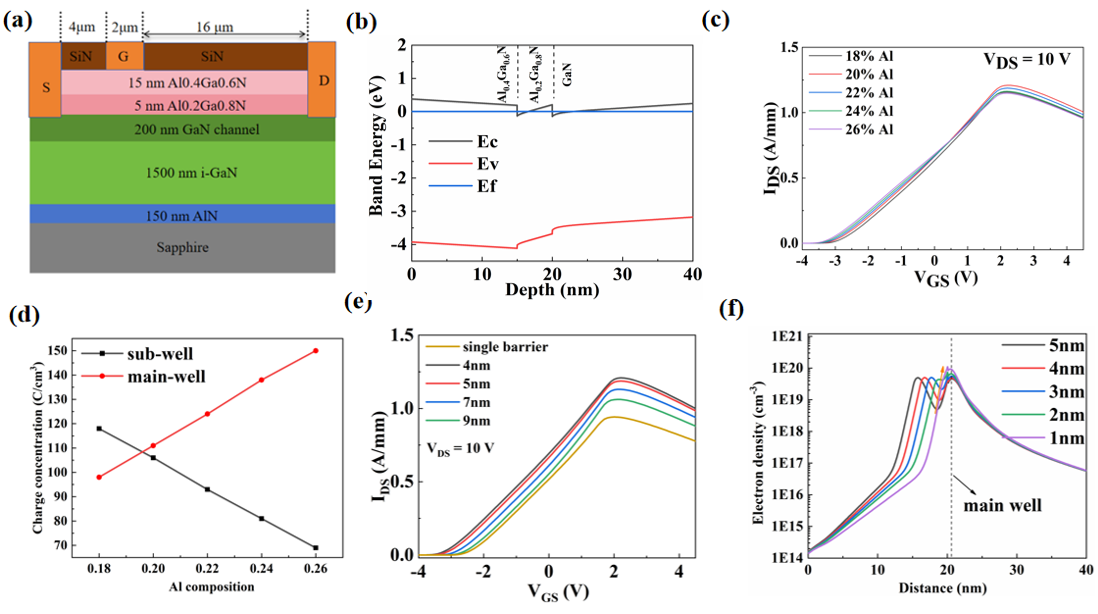
图1.(a)DB-HEMT示意图。(b)Silvaco TCAD模拟的DB-HEMT的能带和费米能级。(c)AlxGa1-xN层具有不同势垒高度的DB-HEMT的传输特性。(d)界面电荷密度与AlxGa1-xN势垒的Al组成之间的关系。(e)具有不同厚度Al0.2Ga0.8N势垒层的DB-HEMT的传输特性。(f)不同厚度Al0.2Ga0.8N势垒层的DB-HEMT的薛定谔-泊松模型模拟的电子密度分布。
论文作者:李磊(博士生),李耀泽,周知剑,何卓昆,刘葆华,罗仟仟,邓建宇(通讯作者),孙文红(通讯作者)。
论文链接://doi.org/10.1063/5.0318911.

 联系地址:广西区南宁市大学东路100号
联系地址:广西区南宁市大学东路100号 联系电话:0771-3237386
联系电话:0771-3237386 邮 编 :530004
邮 编 :530004